ヒートシンクの選択と適用の基本
DigiKeyの北米担当編集者の提供
2020-11-18
ほとんどの電子部品では、特にマイクロプロセッサやマイクロコントローラにおいて、サイズが継続的に縮小しているため、熱密度が増加しています。この結果、寿命、信頼性、性能はデバイスの動作温度に反比例するため、熱設計と管理が設計上の大きな関心事となっています。そのため、設計者は、効果的な熱管理と利用可能なヒートシンクソリューションを明確に理解し、デバイスの動作温度をサプライヤが設定した範囲内に保つ必要があります。
ヒートシンクは、クーラント(空気)にさらされるデバイスの表面積を増やすことで動作します。適切に取り付けられた場合、ヒートシンクは、その熱伝導面を介してより低温の周囲空気への熱伝達を向上させることで、デバイスの温度を低下させます。
この記事では、ヒートシンク選択の概要を説明し、優れた冷却性能を実現するための適切な設計、部品選択、およびベストプラクティスに関するガイダンスを提供します。実例として、Ohmiteのヒートシンクソリューションを使用します。
熱回路
電力は、集積回路(IC)内のアクティブなトランジスタ接合部から熱の形で放散され、接合部の温度は放散される電力に比例します。メーカーは接合部の最大温度を規定していますが、通常は約150°Cです。この接合部温度を超えると一般的にデバイスに損傷を与えるため、設計者はICの熱をできるだけ減らす方法を探さなければなりません。そのために、熱の流れを測定する簡単なモデルに頼ることができます。このモデルは、電気計算のオームの法則に似ており、θで表される熱抵抗の概念に基づいています(図1)。
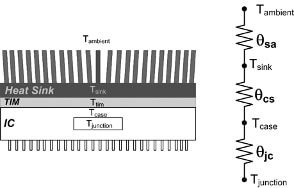 図1:θで表される熱抵抗の概念に基づいたヒートシンク搭載ICの熱回路モデル。(画像提供:DigiKey)
図1:θで表される熱抵抗の概念に基づいたヒートシンク搭載ICの熱回路モデル。(画像提供:DigiKey)
熱抵抗とは、熱がある媒体から別の媒体に流れるときに遭遇する抵抗のことです。1ワットあたりの摂氏(°C/W)単位で測定され、次の式で定義されます。
![]() 式1
式1
ここで、式の要素は次のとおりです。
θは熱バリアの熱抵抗値で、単位は°C/Wです。
∆Tは熱バリアの温度差で、単位は°Cです。
Pは接合部で放散される電力で、単位はWです。
ICとヒートシンクの物理的な配置を見ると、いくつかの熱インターフェースがあります。1つ目は接合部とICのケース間で、熱回路モデルでは熱抵抗θjcで表されています。
ヒートシンクは、2つのデバイス間の熱伝導率を高めるために、サーマルペーストまたはサーマルテープといった熱伝導材料(TIM)を使用してICに取り付けられています。この層は一般的に低抵抗で、ケースとヒートシンク間の熱抵抗θcsで表されています。最後に、ヒートシンクと周囲環境間のインターフェースがθsaで示されています。
熱抵抗は、電子回路の抵抗器のように直列に追加されます。すべての熱抵抗の合計が、接合部と周囲空気間の総熱抵抗となります。
接合部とケース間の熱抵抗は、ICサプライヤによって暗黙的または明示的に規定されるのが一般的です。この仕様は、熱抵抗要素の1つを排除した最大ケース温度の形式である場合があります。ICを適用する設計者は、接合部とケース間の熱抵抗特性を制御することはできません。しかし、設計者は、ICを十分に冷却するために必要なTIMとヒートシンクの特性を選択することができます。これにより接合部温度が規定の最大値を下回ることを維持することができます。一般に、TIMとヒートシンクの熱抵抗が低いほど、冷却されるICのケース温度は低くなります。
ヒートシンクの選択例
OhmiteはBGシリーズのヒートシンクを提供しています。これらの製品は、正方形のパッケージフットプリントを持つボールグリッドアレイ(BGA)やプラスチックボールグリッドアレイ(PGBA)の中央処理装置(CPU)、グラフィック処理ユニット(GPU)、または同様のプロセッサで動作するように設計されています(図2)。
 図2:BGシリーズのヒートシンクは、CPU、GPU、および同様に正方形のフットプリントを持つその他のBGAパッケージICに適しています。(画像提供:Ohmite)
図2:BGシリーズのヒートシンクは、CPU、GPU、および同様に正方形のフットプリントを持つその他のBGAパッケージICに適しています。(画像提供:Ohmite)
製品ラインには10種類のヒートシンク設計が用意されています。フットプリントは15 x 15ミリメートル(mm)~45 x 45mmの一般的なIC構成に対応し、フィン面積は2,060~20,893mm2となっています(表1)。これらのRoHS準拠のヒートシンクは、黒色陽極処理6063-T5アルミ合金で製造されています。
 表1:BGシリーズは2,060~20,893mm2のフィン面積を提供します。(表提供:DigiKey)
表1:BGシリーズは2,060~20,893mm2のフィン面積を提供します。(表提供:DigiKey)
表中の熱抵抗値は自然対流冷却の場合の値です。ファンを用いた強制対流では、冷却空気の速度に比例して熱抵抗が低下します。強制空冷は熱抵抗を1/2~1/3に低減させることができます(図3)。
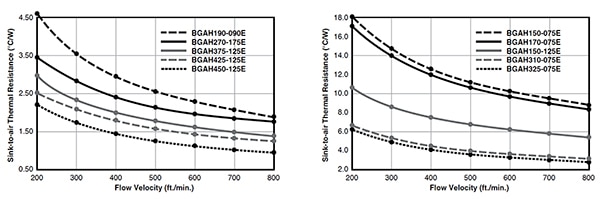 図3:強制空冷でのOhmiteのBGシリーズ ヒートシンクの熱性能。(画像提供:Ohmite)
図3:強制空冷でのOhmiteのBGシリーズ ヒートシンクの熱性能。(画像提供:Ohmite)
熱伝導材料
OhmiteのBGシリーズの場合、ICケースとヒートシンク間に使用される熱伝導材料は、ヒートシンクとともに供給される両面サーマルテープです。両面テープを使用することで、機械的な設計や加工が不要となり、取り付けが容易になります。
一般的に言えば、TIMはワット毎メートル毎摂氏(W/(m·°C))、またはワット毎メートル毎ケルビン(W/(m·K))を単位とする熱伝導率によって規定されます。TIM層の熱抵抗は、テープの厚さとテープが適用される面積に依存します。熱抵抗は次の式で計算することができます。
![]() 式2
式2
ここで、式の要素は次のとおりです。
厚さはメートル(m)で表されます。
面積は平方メートル(m2)で表されます。
熱伝導率は、W/(m·°C)またはW/(m·K)のいずれかで表されます。
摂氏とケルビンは、どちらも同じ温度測定の単位増分を使用しており、計算しているのは温度の差であるため、入れ替えが可能です(たとえば、10°Cの温度変化は10°Kの温度変化に相当します)。
Ohmite BGAH150-075E 15 x 15 x 7.5mmのヒートシンク(15 x 15mmのデバイスに取り付けられます)を見てみると、TIMの面積は225mm2(225E-6m2)となっています。供給されるサーマルテープの厚さは、0.009インチまたは0.23mm(0.00023m)です。規定の熱伝導率は1.4W/(m·K)です。これらの値を式2に使用すると、次のような結果が得られます。
![]() 式3
式3
TIMの熱抵抗は一般的にヒートシンクの熱抵抗よりもはるかに小さくなり、フットプリント面積が大きいヒートシンクの場合はさらに小さくなります。
ICをその温度範囲内に保つためにヒートシンクに必要な最小熱抵抗を決定する例として、まずICから始めます。15 x 15mmのICを考えてみましょう。このICは規定の最大ケース温度が85°Cで、周囲温度45°Cでエンクロージャで動作しながら、通常動作で2Wを消費します。
プロセッサの消費電力を決定するのは、動作モードが多岐にわたるため難しい場合があります。一部のメーカーでは、熱設計電力(TDP)を規定することで、これを簡素化しようとしています。TDPは、「実際のアプリケーション」を実行しているときの消費電力です。この定格の妥当性については、アプリケーションに依存するため、いくらかの議論があります。CPUの各電源電圧の電源電流要件を参照して、最大消費電力を決定することもできます。この値はTDPで説明されている消費電力よりも高い場合があります。設計者は、サプライヤの技術データを参照して、ICの公称消費電力の最良の推定値を決定する必要があります。
例に戻りますが、必要なヒートシンクとTIMの最小熱抵抗(θ)は、式4を用いて求めることができます。
 式4
式4
OhmiteのBGAH150-075Eの熱抵抗は18°C/Wです。TIMの抵抗値0.73°C/Wを加えると、合計18.73°C/Wとなります。これは計算された最小熱抵抗よりも低い値で、機能します。このヒートシンクを選択した場合、周囲温度を一定に保った状態で式1を用いて計算すると、推定最大ケース温度は82.5°Cになります。
代替ヒートシンクとして、フィンの高さが大きいため表面積が大きい15 x 15 x 12.5mmのOhmite BGAH150-125Eを選択することで、ヒートシンクとTIMの総熱抵抗を11°C/Wに低減することができます。これにより、ほぼ同じコストでケース温度を約67°Cに下げることができ、より大きな温度マージンを得ることができます。
その他の考慮事項としては、ヒートシンクの利用可能なスペースや冷却ファンの必要性などが考えられます。
結論
ヒートシンクの選択は、熱的な観点からは比較的簡単です。前述のように、OhmiteのBGシリーズ ヒートシンクは、BGAパッケージICの冷却問題に対する実行可能なソリューションを提供します。

免責条項:このウェブサイト上で、さまざまな著者および/またはフォーラム参加者によって表明された意見、信念や視点は、DigiKeyの意見、信念および視点またはDigiKeyの公式な方針を必ずしも反映するものではありません。


