MPSダイオードによるSiCデバイスの効率向上
DigiKeyの北米担当編集者の提供
2025-03-12
シリコンカーバイド(SiC)はシリコン(Si)よりも優れており、高速バッテリチャージャ、太陽光発電(PV)バッテリコンバータ、およびトラクションインバータなどの用途のショットキーダイオードに特に適しています。 それでもなお、設計者はさらなる効率の改善を迫られています。
SiCデバイスでこれを実現する2つの方法は、リーク電流と熱抵抗による損失を低減することです。 これらの目標を達成することは困難ですが、MPS(Merged PiN Schottky)ダイオードはソリューションを提供します。 MPSデバイスは、ショットキーダイオードのサージ電流性能も向上させます。
この記事では、高電力アプリケーションにおける従来のダイオードを凌ぐSiCショットキーダイオードの利点を説明し、さらなる性能向上が達成できる点をご紹介します。 また、NexperiaのMPSダイオードの例を紹介し、その主な特性をまとめ、設計者がその応用からどのような恩恵を受けられるかを説明します。
SiCショットキーダイオードの利点
従来のSi P-N接合に比べてSiCショットキーダイオードが優れている点は、その基礎となる半導体材料の特性と設計にあります。 SiCはSiよりもバンドギャップが広いという特徴があります。バンドギャップとは、半導体において電子を価電子帯から伝導帯に移動させるのに必要なエネルギーであり、材料の電気伝導性を決定する上で重要な要素です。
SiCのバンドギャップが広いことにより、Siデバイスと比較して、同じ定格電圧の場合、より薄いドリフト層で1桁高い絶縁破壊電界強度を実現します。 ドリフト層とは、従来のダイオードのP層とN層の間にある軽度にドープされた層、またはSiCショットキーダイオードの金属層とP層の間にある層のことです。 ドリフト層を薄くすることで、より小さなダイサイズで、低い抵抗率と優れた電気伝導性能を実現します。
SiCのもう1つの利点は、熱伝導率が約3.5倍優れていることで、これは所定のチップ面積の電力損失を改善します。SiCの最大動作温度はSiのほぼ2倍です。ダイサイズが小さいため、デバイスの自己容量が減少し、特定の電流および電圧定格における関連電荷が少なくなります。 これらの特性とSiCの電子飽和速度の速さにより、損失を低減しながら高速スイッチングが可能になります。
構造的な観点では、従来のP-N接合の代わりに、ショットキーダイオードはP型を排除し、代わりにN型材料に結合した金属の薄層(白金、タングステン、金、またはその他の金属)を使用します。この結合により、ショットキーバリアと呼ばれる金属-半導体(M-S)接合が形成されます(図1)。
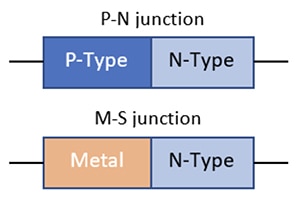 図1:ショットキーダイオードは、従来のダイオードのP型半導体(上)を金属で置き換えてM-S接合(下)を形成します(画像提供:DigiKey)
図1:ショットキーダイオードは、従来のダイオードのP型半導体(上)を金属で置き換えてM-S接合(下)を形成します(画像提供:DigiKey)
M-S接合では、順方向および逆方向のバイアス条件下において、P-N接合よりも狭い電子空乏領域が生成されます(図2)。この狭い空乏領域により、ショットキーダイオードには重要な利点が生まれます。それは、従来のダイオードよりも順方向電圧(VF)が低いことです。順方向バイアスの場合、P-N接合の0.6~0.7ボルトに比べ、ショットキーダイオードでは通常数百ミリボルトで伝導がスタートします。 この特性は、バッテリ駆動機器などの低電力アプリケーションに有利です。
 図2:ショットキーダイオードの空乏領域は、順方向および逆方向のバイアス条件下でより狭くなり、その結果、順方向電圧が低くなり、損失が減少します。(画像提供:DigiKey)
図2:ショットキーダイオードの空乏領域は、順方向および逆方向のバイアス条件下でより狭くなり、その結果、順方向電圧が低くなり、損失が減少します。(画像提供:DigiKey)
ショットキーデバイスは、多数キャリア(電子)を通してのみ伝導するため、部品が順方向にバイアスされた場合、ダイオードの接合空乏層に蓄積される電荷はごくわずかになります。 これにより、ダイオードが順方向バイアスから逆方向バイアスに切り替わる際の損失(および電力損失)が制限されます。 対照的に、P-N接合ダイオードは少数キャリアと多数キャリアを通して伝導するため、空乏層に蓄積される電荷は多くなります。 その結果、P-Nデバイスではスイッチング損失が増加し、周波数が高くなるほど損失も増加します。
全体的には、ショットキーダイオードはP-Nデバイスよりも消費電力が少なく、高電力アプリケーションにおいて放熱効率が高い傾向があります。 ショットキーダイオードから放散される熱が減少することで、より高い温度に耐えることができ、熱暴走のリスクなしに堅牢な性能と優れた信頼性を実現できます。
ショットキーダイオードの狭い空乏領域には、さらなる利点があります。それは、部品の静電容量を低く抑えられることです。 SiCダイオードの「ソフトスイッチング」動作と併せて、この低静電容量は電磁妨害(EMI)を大幅に低減します。
SiCショットキーダイオードをさらに改善する方法
SiCショットキーダイオードは改善を続けています。 たとえば、現代のSiCデバイスの狭い空乏領域は、M-Sインターフェースの製造時に発生する不完全性の影響を拡大し、ダイオードが逆バイアスされた際に高いリーク電流を引き起こします。さらに、空乏領域が狭いため、SiCショットキーダイオードは高い逆電圧(VR)に耐えることができません。 ショットキーダイオードが数十ボルトのVRに耐えられるのに対し、P-N接合は数百ボルトに耐えられます。
SiCダイオードの高いリーク電流に対処する1つの方法は、ダイオードのドリフト層と基板を厚くすることです。 しかし、これは電気抵抗と熱抵抗を増大させ、所定の電流に対してVFと接合部温度(TJ)を上昇させます。さらに、ドリフト層が厚くなることで抵抗が増大し、サージ電流性能に影響を与える可能性があります。
Nexperiaは、MPSダイオードでこの課題に対処しました。 Nexperia PSCシリーズのMPS構造は、SiCショットキーとP-Nデバイスの2種類のダイオードを並列に配置して使用します。 従来のショットキーデバイスのドリフトゾーンにPドープ「ウェル」を注入することで、ショットキーアノードの金属とのPオーミックコンタクトが形成され、軽度にドープされたSiCドリフト層またはエピ層とのP-N接合が形成されます(図3)。
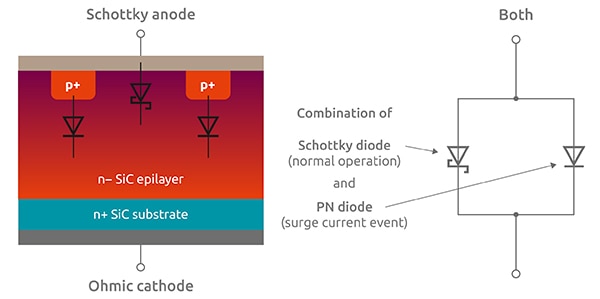 図3:MPS構造は、SiCショットキーとP-Nデバイスの2種類のダイオードを並列に配置して使用します。Pドープ領域をドリフトゾーンに注入することで、金属とのPオーミックコンタクトが形成され、SiCドリフト層またはエピ層とのP-N接合が形成されます。(画像提供:Nexperia)
図3:MPS構造は、SiCショットキーとP-Nデバイスの2種類のダイオードを並列に配置して使用します。Pドープ領域をドリフトゾーンに注入することで、金属とのPオーミックコンタクトが形成され、SiCドリフト層またはエピ層とのP-N接合が形成されます。(画像提供:Nexperia)
逆バイアス下では、Pドープウェルは最大電界強度を、欠陥のほとんどないドリフト層の下に「押し下げる」ことで、欠陥のある金属バリアから遠ざけ、全体的なリーク電流を減少させます(図4)。
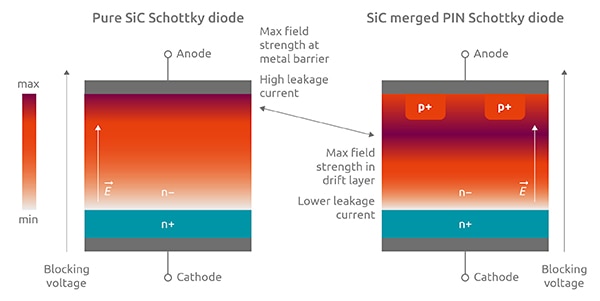 図4:SiCショットキーダイオードにPドープウェルを追加すると、逆バイアス下での最大電界強度の領域がアノード金属から離れます。その結果、リーク電流が減少します。(画像提供:Nexperia)
図4:SiCショットキーダイオードにPドープウェルを追加すると、逆バイアス下での最大電界強度の領域がアノード金属から離れます。その結果、リーク電流が減少します。(画像提供:Nexperia)
最終的な特性と、リーク電流やサージ電流と引き換えになるVF降下に影響を与えるのはPドープウェルの配置、面積、ドーピング濃度です。そのため、MPSデバイスは、同じリーク電流およびドリフト層厚さの従来型SiCダイオードよりも高い降伏電圧で動作することができます。
ショットキーダイオード(ユニポーラデバイス)とP-Nダイオード(バイポーラ)のハイブリッド型組み合わせにより、通常の状態ではP-N接合が導通せず、その結果、逆回復損失がほとんど発生しません。 しかし、過渡過電流事象が発生した際にはP-Nダイオードが導通するため、ハイブリッド構成はサージ電流定格を改善し、ハイブリッド部品を効果的に保護します。
MPSダイオードは公称条件下でショットキーダイオードのように動作するため、このデバイスは純粋な容量性スイッチング動作を示します。その結果、同じ電気定格のSi高速リカバリダイオードよりも逆回復電荷(QRR)が低くなります。QRRは、ダイオードに蓄積された電荷であり、ダイオードが逆電圧を遮断する前に再結合する必要があります。QRRは、Siダイオードの主な損失要因の1つです。
図5は、SiダイオードとSiCダイオード(NexperiaのPSC1065HJ)の逆回復動作を比較したものです。 SiCダイオードは純粋な容量性スイッチングを示し、QRRは最小限に抑えられています。 QRRは、IF = 0軸下のグラフの面積に相当します。
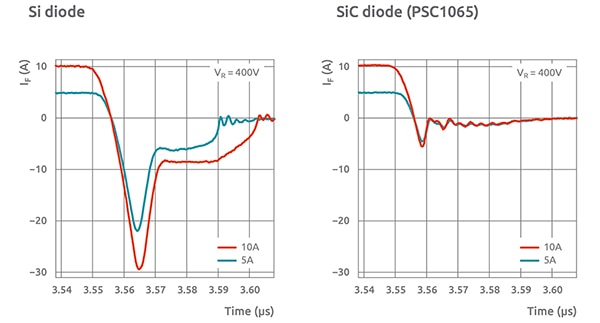 図5:SiCダイオード(右)と比較したSiダイオード(左)の逆回復動作を示しています。SiCダイオードは純粋に容量性スイッチングを示し、QRRが最小限に抑えられています。(画像提供:Nexperia)
図5:SiCダイオード(右)と比較したSiダイオード(左)の逆回復動作を示しています。SiCダイオードは純粋に容量性スイッチングを示し、QRRが最小限に抑えられています。(画像提供:Nexperia)
製造時のドリフト層厚さの低減
MPSダイオードは、従来のSiCダイオードと比較してリーク電流を大幅に削減しているため、ドリフト層の厚さを削減することによるメリットが得られます。 前述の通り、従来のSiCダイオードでは、リーク電流を低く抑えるために、ドリフト層はSiダイオードで使用されるものよりも厚くなっています。
製造時に、加工されていないSiC基板にNドープを施し、SiCエピタキシャル層を成長させるとドリフト領域が形成されます。 基板の厚さは最大500µmにもなり、これにより接合部から裏面金属までの電流および熱の流れの経路における電気抵抗および熱抵抗が増加します。 その結果、所定の電流に対するVF降下およびTJが増加します。
ドリフト層の電気抵抗および熱抵抗を低減する解決策は、製造工程で基板下面を研磨して厚みを減らすことです(図6)。 その結果、MPSダイオードが得られ、所定の動作条件下では、同等のSiCダイオードと比べて動作温度の低下、信頼性の向上、サージ電流耐性の向上、VF降下の低下というメリットがもたらされます。
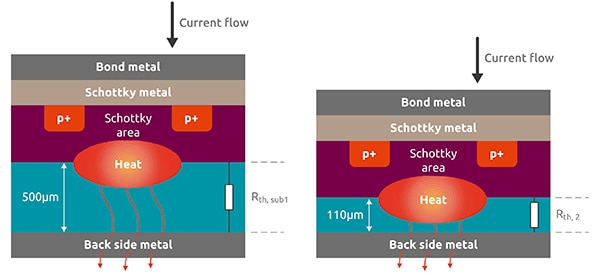 図6:基板下面の厚みを薄くすることで(右)、MPSダイオードが得られます。MPSダイオードは、同等のSiCダイオードと比べて動作温度の低下、信頼性の向上、サージ電流耐性の向上、VF降下の低下を実現します。(画像提供:Nexperia)
図6:基板下面の厚みを薄くすることで(右)、MPSダイオードが得られます。MPSダイオードは、同等のSiCダイオードと比べて動作温度の低下、信頼性の向上、サージ電流耐性の向上、VF降下の低下を実現します。(画像提供:Nexperia)
商用オプション
Nexperiaは、バッテリ充電インフラ、サーバおよび通信機器の電源、無停電電源装置、PVインバータなど、多様な用途向けのMPSダイオードを幅広く提供しています。
PSC0665HJ(図7)は、DPAK R2P(TO-252-2)面実装パッケージに封止されたMPS SiCショットキーダイオードです。 接合部からケースまでの熱抵抗(Rth(j-c))は2.7ケルビン/ワット(K/W)です。 総電力損失(Ptot)(Tc ≤ +25°C)は115Wです。このダイオードは、温度に依存しない容量性ターンオフとゼロリカバリスイッチング動作を、優れた性能指数(FOM)(FOM = 総容量電荷(QC) x VF)とともに提供します。 この部品は、高い非繰り返しピーク順方向電流(IFSM)により示されるように、強固なサージ電流保護を提供します。
 図7:PSC0665HJは、DPAK R2P(TO-252-2)に封止されたMPS SiCショットキーダイオードです。(画像提供:Nexperia)
図7:PSC0665HJは、DPAK R2P(TO-252-2)に封止されたMPS SiCショットキーダイオードです。(画像提供:Nexperia)
PSC0665HJのQCは14ナノクーロン(nC)(VR = 400V; dIF/dt = 200A/µs; 順方向電流(IF) ≤ 6A; TJ = +25°C)で、VF = 1.5V (IF = 6A; TJ = +25°C)です。 これにより、ダイオードのFOMは14nC x 1.5V = 21ナノジュール(nJ)となります。
最大繰り返しピーク逆電圧(VRRM)は650Vです。逆電流(IR)は+25°Cで1µA、VRは650Vです。最大順方向電流(IF)は6A、最大IFSMは300A(tp = 10µs; 矩形波; Tc = +25°C)または36A(tp = 10ms; 半正弦波; Tc = +25°C)です。
PSC2065LQは、Nexperia MPS SiCショットキーダイオードファミリの製品です。 このデバイスは、TO247 R2P(TO-247-2)スルーホールパワープラスチックパッケージに封止されています。 接合部からケースまでの熱抵抗(Rth(j-c))は1Wです。 Ptot(Tc ≤ +25°C)は115Wです。
PSC2065LQのQCは41nC(VR = 400V; dIF/dt = 200A/µs; IF ≤ 20A; Tj = +25°C)で、VF = 1.5V (IF = 20A; TJ = +25°C)です。これにより、FOMは41nC x 1.5V = 61.5nJとなります。
VRRMは650Vです。IRは+25°CでVRが650Vの場合、1µAです。最大IFは10A、最大IFSMは440A(tp = 10µs; 矩形波; Tc = +25°C)または52A(tp = 10ms; 半正弦波; Tc = +25°C)です。
まとめ
SiCショットキーダイオードは、Siと比較して、出力電力やシステム全体の効率を犠牲にすることなく、大幅に優れたスイッチング性能や高いスイッチング周波数などの優れた技術的利点を提供します。 NexperiaのハイブリッドMPS構造では、SiCショットキーダイオードをP-Nダイオードと並列に利用することで、SiCショットキーダイオードの性能をさらに向上させています。 その結果、所定の動作条件下では、同等のSiCダイオードと比べて動作温度の低下、信頼性の向上、サージ電流耐性の向上、VF降下の低下を実現します。

免責条項:このウェブサイト上で、さまざまな著者および/またはフォーラム参加者によって表明された意見、信念や視点は、DigiKeyの意見、信念および視点またはDigiKeyの公式な方針を必ずしも反映するものではありません。





